Our Products
HTCC Packaging Shell
HTCC ceramic packaging solutions for IC, RF, optical communication, and power device applications, offering multilayer interconnection, thermal stability, and reliable performance.
Monolithic Integrated Circuit Packaging
Integrated circuit packaging is currently the most common and widely used ceramic packaging shell. The product series includes:
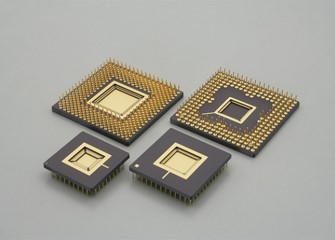
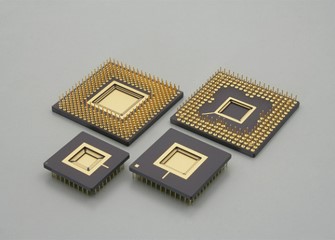






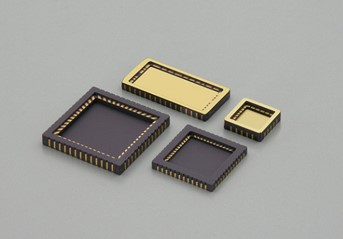
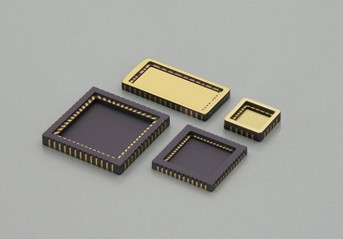


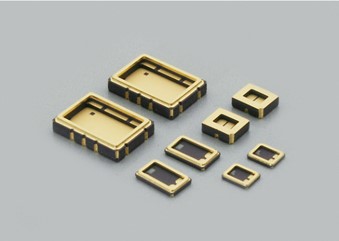
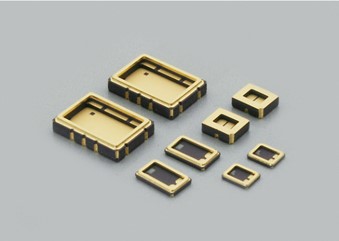
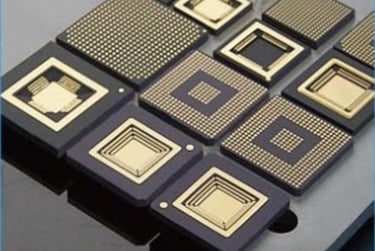
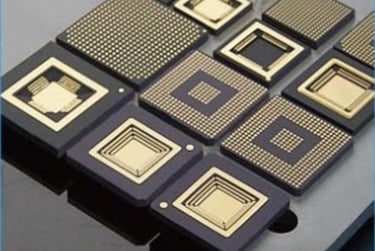
CSMD
Optical communication device packging shell
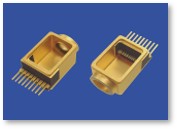
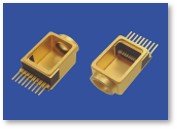
TOSA/ROSA shell
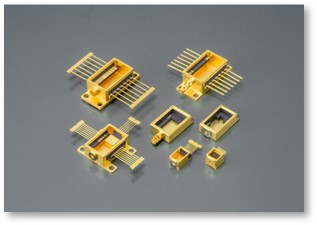
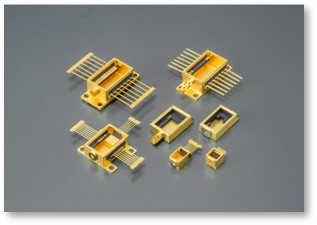
Butterfly shaped optoelectronic
Photoelectric detection device packging shell
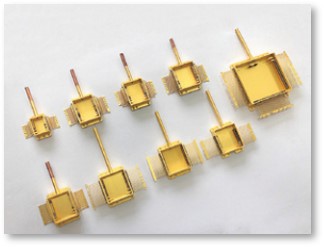
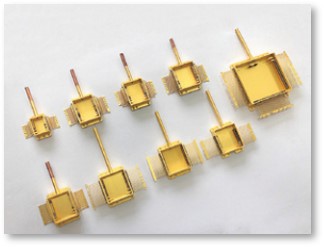
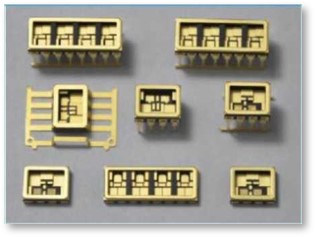
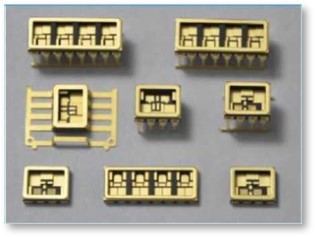
Uncooled infrared detector
Hybrid IC ceramic housing for optocouplers
Packaging Shell for Microwave Wireless Commnication Devices


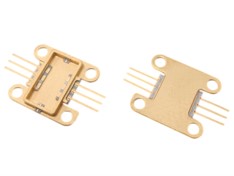
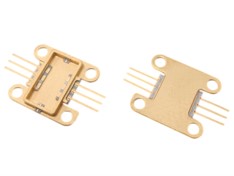


Microwave solid-state power device
Ceramic substrate for microwave components
CSOP
CDIP
CFP
CLCC
CQFN
CPGA
CLGA/CBGA
Metal ceramic case for monolithic circuits


DPC Substrate
DPC ceramic substrates provide fine-line copper patterning, strong adhesion, and excellent thermal performance for optoelectronic and advanced packaging applications.
DPC Subtrate Applications / DPC-based packages


LED Packaging
LD Submount
RF & Microwave Device Package


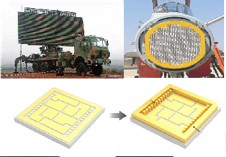
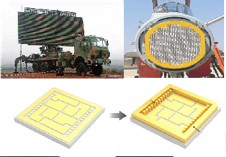


VCSEL LD Packaging


High-Temperature Electronic Packaging
High-Frequency Compact Oscilator Packaging
DPC substrates use semiconductor processes to deposit copper patterns on ceramic, providing precise circuits with high adhesion and thermal performance
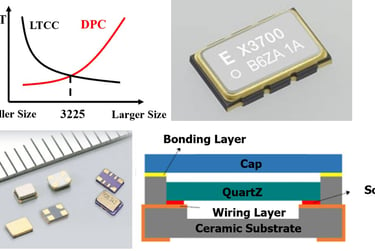
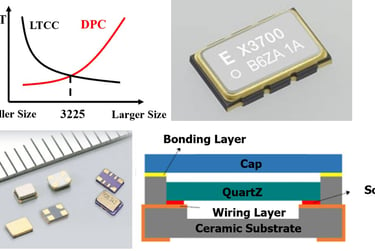
AMB Substrate
AMB (Active Metal Brazing) ceramic substrates are designed for high-power and high-reliability applications, offering strong bonding performance and excellent thermal conductivity.